JSR、平成27年度第64回日本化学会化学技術賞を受賞
ーArF液浸リソグラフィ用トップコート材料の開発に対してー
企業情報
JSR株式会社(社長:小柴 満信)は、この度「ArF液浸リソグラフィ用トップコート材料の開発」の実績により、下記5名の受賞者が公益社団法人日本化学会の平成27年度第64回日本化学会化学技術賞を受賞し、3月26日(土)に同志社大学京田辺キャンパスで行われた日本化学会第96春季年会において表彰されましたことをお知らせいたします。
日本化学会は、1878年(明治11年)に創立され140年近い歴史を持つ、会員約3万名を擁する国内最大の化学分野の学会です。毎年、学術・産業分野において顕著な業績をあげた研究に携わった団体と個人が表彰されています。JSRが開発したトップコート材料は2006年の商品化と共にArF液浸リソグラフィの標準材料となり、ArF液浸リソグラフィ技術の早期実用化を可能とし、LSIの微細化推進に大きく貢献したことが評価され、今回の受賞となりました。
<受賞者>
ArF液浸リソグラフィは、パソコンやスマートフォンなどの心臓部として使用される最先端の大規模集積回路(LSI)の製造に使われている微細パターン露光技術です(参考資料1)。微細パターンを投影するレンズとフォトレジストの間を空気より屈折率の高い純水で満たすことでレンズの分解能を高め、それまでできなかった微細な線幅のパターン転写を実現しています。
今回の受賞対象であるトップコート材料は、フォトレジストと純水が直に接することで発生する不具合を防止するために液浸露光を行う前にフォトレジスト上に塗布される保護膜材料です(参考資料2)。高い撥水性によりレジスト膜中への水の浸入を防ぐともに、ArF液浸露光ステージの高速安定動作も可能にします。フォトレジストを始めとするJSRの長年のリソグラフィ材料開発の知見を活かして新規開発したフッ素アルコール含有樹脂を用いて設計したもので、十分な撥水性を持つだけでなくフォトレジストの現像に使われるアルカリ現像液への溶解性を付与することに成功しました。これにより、フォトレジストのパターン現像と共にトップコート材料の剥離が可能となり、リソグラフィ工程の大幅な簡略化も実現しました(参考資料3)。
<参考資料>
1.フォトレジスト高解像度化の歴史:
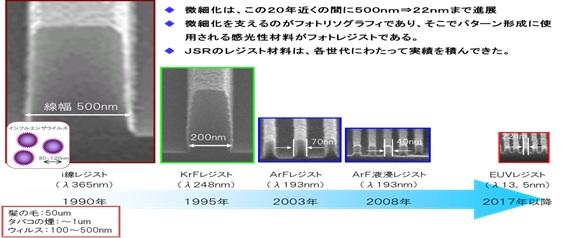
2.液浸リソグラフィ技術:
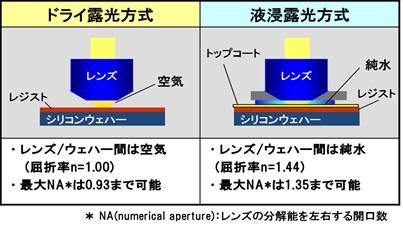
3.ArF液浸リソグラフィ用トップコートを使用した工程例:
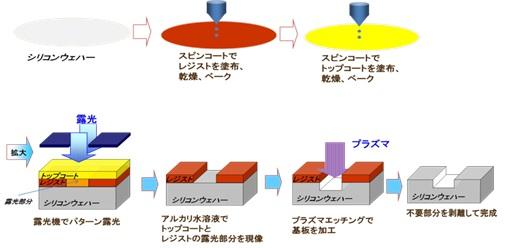
日本化学会は、1878年(明治11年)に創立され140年近い歴史を持つ、会員約3万名を擁する国内最大の化学分野の学会です。毎年、学術・産業分野において顕著な業績をあげた研究に携わった団体と個人が表彰されています。JSRが開発したトップコート材料は2006年の商品化と共にArF液浸リソグラフィの標準材料となり、ArF液浸リソグラフィ技術の早期実用化を可能とし、LSIの微細化推進に大きく貢献したことが評価され、今回の受賞となりました。
<受賞者>
| 島 基之 | JSR株式会社 精密電子研究所 半導体材料開発室長 | |
| 杉江 紀彦 | JSR株式会社 精密電子研究所 プロセス材料開発室 | |
| 草開 一憲 | JSR株式会社 製造技術第二センター 第一チーム | |
| 中川 大樹 | JSR株式会社 精密電子研究所 半導体材料開発室 | |
| 千葉 隆 | JMエナジー株式会社 開発部長 |
ArF液浸リソグラフィは、パソコンやスマートフォンなどの心臓部として使用される最先端の大規模集積回路(LSI)の製造に使われている微細パターン露光技術です(参考資料1)。微細パターンを投影するレンズとフォトレジストの間を空気より屈折率の高い純水で満たすことでレンズの分解能を高め、それまでできなかった微細な線幅のパターン転写を実現しています。
今回の受賞対象であるトップコート材料は、フォトレジストと純水が直に接することで発生する不具合を防止するために液浸露光を行う前にフォトレジスト上に塗布される保護膜材料です(参考資料2)。高い撥水性によりレジスト膜中への水の浸入を防ぐともに、ArF液浸露光ステージの高速安定動作も可能にします。フォトレジストを始めとするJSRの長年のリソグラフィ材料開発の知見を活かして新規開発したフッ素アルコール含有樹脂を用いて設計したもので、十分な撥水性を持つだけでなくフォトレジストの現像に使われるアルカリ現像液への溶解性を付与することに成功しました。これにより、フォトレジストのパターン現像と共にトップコート材料の剥離が可能となり、リソグラフィ工程の大幅な簡略化も実現しました(参考資料3)。
<参考資料>
1.フォトレジスト高解像度化の歴史:
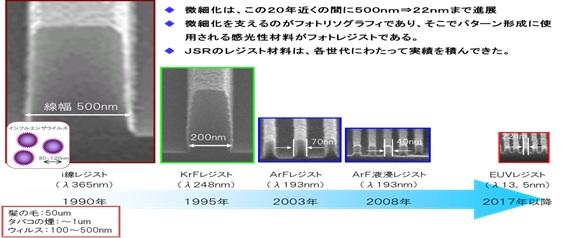
2.液浸リソグラフィ技術:
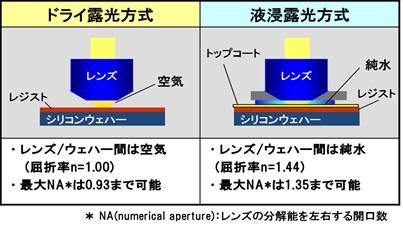
3.ArF液浸リソグラフィ用トップコートを使用した工程例: