JSR、ダブルパターニング向け、ノントップコート自己架橋型ArFフォトレジスト開発
 2010年02月22日
2010年02月22日
JSR株式会社(社長:小柴満信)は、線幅32ナノメートルハーフピッチ以降の次世代半導体製造方法である「ダブルパターニング」用材料として、トップコートが不要な自己架橋型ArFフォトレジストを開発し、線幅26ナノメートルハーフピッチの加工(参考資料 1)に成功しました。昨年6月にトップコートを必要とする「自己架橋型ArFフォトレジスト」を発表して以来、半導体製造工程におけるプロセスのコストダウンおよび多様化の要求に対応するために検討を続けてきた成果です。
半導体業界は、スマートフォン、音楽プレイヤーなどのデジタル機器の発展や、音楽、動画、写真などの大容量コンテンツの処理を実現するためのパーソナルコンピュータの高性能化や省電力化のために今後も微細化が進行していきます。こうした顧客の技術進化に対応すべく、当社は、基盤事業である半導体材料事業をさらに拡充してまいります。
詳細は、2010年2月21日から米国カリフォルニア州サンノゼ市で開催している半導体製造のリソグラフィ技術に関する国際会議「SPIE Advanced Lithography 2010」で発表します。当社の発表日は現地時間2月24日です(講演番号 7639-39)。
今回発表するトップコートが不要な自己架橋型ArFフォトレジストは、熱硬化の機能を有しており、加熱処理により材料自体が硬化することで2度目の露光用フォトレジストに不溶になります。また、トップコートがなくても、液浸露光の課題となっている水滴欠陥を最小限に抑え、フォトレジストからの溶出物質が露光装置の高性能かつ繊細なレンズ表面に悪影響を及ぼさずに露光できることを証明しました。これにより、ダブルパターニングにおける製造プロセスをさらに簡略化することができるようになります。加えて、次世代露光機での高速スキャン耐性も向上しており、顧客の生産性向上に貢献します。
当社ではフリージング材と最先端ArFフォトレジストを組み合わせて使用する方式、自己架橋型ArFフォトレジストに業界標準となっている液浸露光用トップコートTCXシリーズを組み合わせて使用する方式、そして今回開発したトップコートが不要な自己架橋型ArFフォトレジストを使用する方式を有することになり、顧客の選択する製造工程に合わせた様々なソリューションの提供が可能になりました。
(参考資料 2)
また今回、上記自己架橋型ArFフォトレジストに、当社の有機と無機の塗布型ハードマスク材料を適用することで、実際のデバイス製造のようにシリコン基板の微細なパターン加工にも成功しました。
(参考資料 3)
当社は、ArFフォトレジストをはじめ、液浸露光用トップコートTCXシリーズ、塗布型ハードマスク材料、高密度実装用材料、CMP材料など、次世代半導体製造に必須である最先端半導体材料の総合的な開発を進めており、高品質・高性能な製品を、世界市場へ供給しております。
<参考資料>
1.26ナノメートルハーフピッチ トップダウンと断面SEM写真
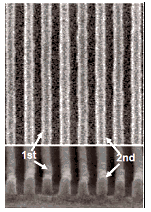
2.フリージング材使用のプロセスと自己架橋型レジスト使用プロセスの比較
3. JSR塗布型ハードマスクを使用した加工例
半導体業界は、スマートフォン、音楽プレイヤーなどのデジタル機器の発展や、音楽、動画、写真などの大容量コンテンツの処理を実現するためのパーソナルコンピュータの高性能化や省電力化のために今後も微細化が進行していきます。こうした顧客の技術進化に対応すべく、当社は、基盤事業である半導体材料事業をさらに拡充してまいります。
詳細は、2010年2月21日から米国カリフォルニア州サンノゼ市で開催している半導体製造のリソグラフィ技術に関する国際会議「SPIE Advanced Lithography 2010」で発表します。当社の発表日は現地時間2月24日です(講演番号 7639-39)。
今回発表するトップコートが不要な自己架橋型ArFフォトレジストは、熱硬化の機能を有しており、加熱処理により材料自体が硬化することで2度目の露光用フォトレジストに不溶になります。また、トップコートがなくても、液浸露光の課題となっている水滴欠陥を最小限に抑え、フォトレジストからの溶出物質が露光装置の高性能かつ繊細なレンズ表面に悪影響を及ぼさずに露光できることを証明しました。これにより、ダブルパターニングにおける製造プロセスをさらに簡略化することができるようになります。加えて、次世代露光機での高速スキャン耐性も向上しており、顧客の生産性向上に貢献します。
当社ではフリージング材と最先端ArFフォトレジストを組み合わせて使用する方式、自己架橋型ArFフォトレジストに業界標準となっている液浸露光用トップコートTCXシリーズを組み合わせて使用する方式、そして今回開発したトップコートが不要な自己架橋型ArFフォトレジストを使用する方式を有することになり、顧客の選択する製造工程に合わせた様々なソリューションの提供が可能になりました。
(参考資料 2)
また今回、上記自己架橋型ArFフォトレジストに、当社の有機と無機の塗布型ハードマスク材料を適用することで、実際のデバイス製造のようにシリコン基板の微細なパターン加工にも成功しました。
(参考資料 3)
当社は、ArFフォトレジストをはじめ、液浸露光用トップコートTCXシリーズ、塗布型ハードマスク材料、高密度実装用材料、CMP材料など、次世代半導体製造に必須である最先端半導体材料の総合的な開発を進めており、高品質・高性能な製品を、世界市場へ供給しております。
<参考資料>
1.26ナノメートルハーフピッチ トップダウンと断面SEM写真
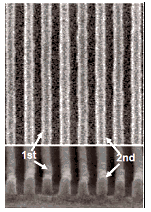
2.フリージング材使用のプロセスと自己架橋型レジスト使用プロセスの比較
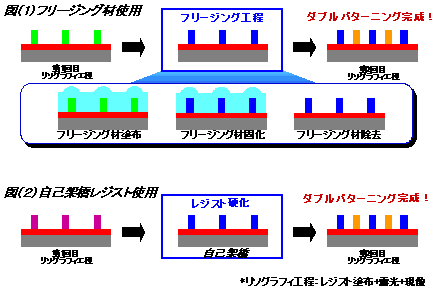 | 左図(1)は、フリージング材を用いる方法で、図(2)は、自己架橋型フォトレジストを使用する方法。今回開発したノントップコート自己架橋型レジストを使用すると、左図(2)の「第1回目リソグラフィ工程」の際に、トップコートを使用せずにリソグラフィ工程を実施するため、トップコートを塗布する工程が省略できます。 |
| 微細化に伴い、フォトレジストは膜厚が薄くなり、直接酸化膜をエッチングすることが困難になります。そのための、フォトレジストと酸化膜の間に無機・有機2層ハードマスクを塗布し、上層から順にエッチングを行なうことで、酸化膜の微細加工を実現させます。 | 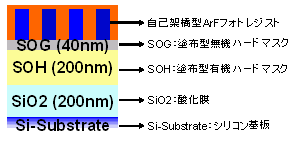 |
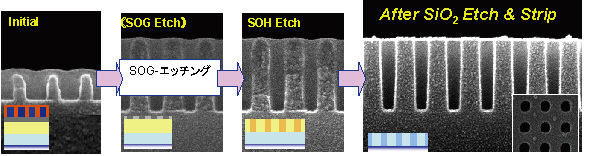 | |
| 「データ協力:(株)日立ハイテクノロジーズ様」 | |




