JSRとSEMATECH、化学増幅型EUV向けレジストとして世界初の15ナノメートルパターン解像に成功
~EUVリソグラフィの量産適用に向け大きな一歩~
 2011年10月20日
2011年10月20日
JSR株式会社(社長:小柴満信)は、米国の半導体製造技術研究組合であるSEMATECH(セマテック、米テキサス州)と共同で、世界で初めてEUV(Extreme Ultraviolet:遠紫外線)リソグラフィを用いて15ナノメートルハーフピッチ*1のパターンが化学増幅型フォトレジスト(感光性樹脂)で形成できることを実証しました。今回、10ナノメートルレベルのパターン形成を実現したことにより、EUVリソグラフィの実用化に向けて大きく前進しました。
*1:15ナノメートルハーフピッチとは、15ナノメートルの等間隔パターンです。
EUVの露光波長は13.5ナノメートルと、現在最先端の半導体製造で使われているArF(193ナノメートル)に比較して1/10以下であり、解像度に優れていると言われています。しかし、現在、一般的に使用されている化学増幅型フォトレジストでは、感度は優れるものの、解像度においては当社が2011年3月に発表した19ナノメートルハーフピッチが最も微細なパターンでした。今回、当社は、露光によって発生する酸の拡散による解像度低下という化学増幅型フォトレジストの問題に対して、酸の拡散挙動の制御をはじめとする精密な材料設計により、15ナノメートルハーフピッチの解像が可能なEUV用化学増幅型フォトレジストを開発しました。
詳細は、米国フロリダ州マイアミ市で開催されるEUVリソグラフィ技術に関する国際会議「2011 International Symposium on Extreme Ultraviolet Lithography」にてSEMATECHから発表されます。発表日は10月19日(米国時間)です。
なお、15ナノメートルハーフピッチのパターン形成については、非化学増幅型フォトレジストを用いた結果が、今春、米国で行われたリソグラフィ分野の国際学会「SPIE Advanced Lithography 2011」で発表されていますが、今回当社が開発したフォトレジストに比較して感度が1/2以下と低いことが実用上の課題でした。
半導体製品はコンピュータ分野だけでなく通信・自動車・家電・医療分野などへと多様化しながら人々の生活に浸透しており、さらなる進化のため小型化・高速化が強く望まれています。これら市場の要求を満たすソリューションとして、半導体回路の微細化とそれに伴うパターニング解像度の微細化には強い期待が集まっています。当社はフォトレジストを中心としたEUVリソグラフィ技術に最適な材料群の開発を積極的に進め、高品質で高性能な製品を世界市場に供給することで、半導体業界のニーズに対応してまいります。
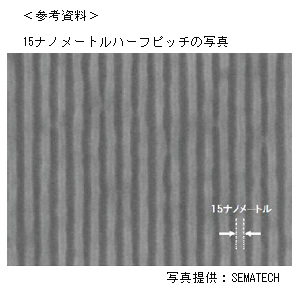
*1:15ナノメートルハーフピッチとは、15ナノメートルの等間隔パターンです。
EUVの露光波長は13.5ナノメートルと、現在最先端の半導体製造で使われているArF(193ナノメートル)に比較して1/10以下であり、解像度に優れていると言われています。しかし、現在、一般的に使用されている化学増幅型フォトレジストでは、感度は優れるものの、解像度においては当社が2011年3月に発表した19ナノメートルハーフピッチが最も微細なパターンでした。今回、当社は、露光によって発生する酸の拡散による解像度低下という化学増幅型フォトレジストの問題に対して、酸の拡散挙動の制御をはじめとする精密な材料設計により、15ナノメートルハーフピッチの解像が可能なEUV用化学増幅型フォトレジストを開発しました。
詳細は、米国フロリダ州マイアミ市で開催されるEUVリソグラフィ技術に関する国際会議「2011 International Symposium on Extreme Ultraviolet Lithography」にてSEMATECHから発表されます。発表日は10月19日(米国時間)です。
なお、15ナノメートルハーフピッチのパターン形成については、非化学増幅型フォトレジストを用いた結果が、今春、米国で行われたリソグラフィ分野の国際学会「SPIE Advanced Lithography 2011」で発表されていますが、今回当社が開発したフォトレジストに比較して感度が1/2以下と低いことが実用上の課題でした。
半導体製品はコンピュータ分野だけでなく通信・自動車・家電・医療分野などへと多様化しながら人々の生活に浸透しており、さらなる進化のため小型化・高速化が強く望まれています。これら市場の要求を満たすソリューションとして、半導体回路の微細化とそれに伴うパターニング解像度の微細化には強い期待が集まっています。当社はフォトレジストを中心としたEUVリソグラフィ技術に最適な材料群の開発を積極的に進め、高品質で高性能な製品を世界市場に供給することで、半導体業界のニーズに対応してまいります。